6. PVD设备的实况

图6.1 批量式真空蒸镀设备 17)
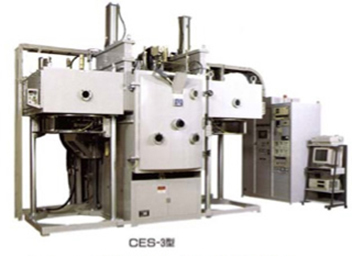
图6.2 连续式真空蒸镀设备 17)
根据基片加工方式,设备构成可分为图6.1所示的批量处理方式和图6.2所示的连续处理方式。
批量处理方式是在单个真空室内进行以下循环:安装基片→排气和基片加热→成膜→基片冷却→大气开放→取出基片。
连续处理方式,除了成膜室外,还有基片供应室和取出室,成膜室由闸阀等隔断阀隔开。因为无需将成膜工艺室暴露在大气中就能供应基片,因此这种方式的特点是生产率高。成膜设备中的重要构成要素说明如下。
6.1 真空室
如前所述,真空室的结构材料必须采用尽可能降低气体释放和渗透的材料。过去使用的是玻璃,但现在通常使用不锈钢或镀镍的低碳钢。
6.2 真空排气系统
成膜设备组合使用粗排排气系统与高真空排气系统。设计是根据处理材料的特性、薄膜的特性要求和处理量等来确定合适的泵的类型和排气速度。

图6.3 高真空排气系统的系统图 1)
图6.3为典型真空排气系统的系统图。 图6.3中的扩散泵可以用低温泵或涡轮分子泵代替,系统图无变化。然而,由于低温泵是捕集式泵,图中位于扩散泵后面的阀门动作会有所不同。换句话说,如果是低温泵,必须在排出一定体积后进行泵的再生,而该体积取决于泵捕集极限的气体量。
真空泵应用了各种原理,根据其原理也限制了有效工作的压力范围。图6.4为表示各种泵排气速度S[m3/s]与压力p[Pa]关系的S-P曲线。

图6.4 各种真空泵的S-P曲线 1)
6.3 基片架
为了获得均匀的薄膜质量和厚度,需要根据基片的形状采取各种动作方式。在镜头和晶圆的蒸发系成膜中,会让伞状架旋转或行星式旋转。在溅射系中,经常使用旋转平板架的方法或转盘式。在串联式连续设备中,采用的是使用托盘的通过成膜方法。
6.4 膜厚计
在成膜过程中,有必要用膜厚计监测膜厚,以检测是否已沉积到所需膜厚。安装在真空室中的膜厚计有两种类型:石英晶体膜厚计和光学膜厚计。
在光学薄膜中,利用光干涉现象的光学膜厚计可以很好地控制薄膜品质和薄膜厚度的再现性。溅射法时通过控制时间来控制膜厚。
6.5 气体导入机构
成膜时,必须根据需要导入气体。有两种方法:一种是使用质量流量控制器(MFC:Mass Flow Controller)保持恒定的气体流量,另一种是改变气体流量以保持恒定压力的自动压力控制器(APC:Automatic Pressure Controller)。
6.6 基片加热机构
如果基片具有耐热性,可以通过加热成膜来改善附着力和薄膜特性。镍铬、钨和石墨等灯丝材料以及卤素灯等光源被用作加热器。
6.7 设备控制系统
随着计算机的发展和普及,计算机自动控制已成为设备控制的常用控制方法。另外,通过自动控制,能忠实、简单地执行成膜的各种参数,消除了人为错误,大大改善了可再现性。




