9. SHINCRON成膜设备的成膜案例与用途
自1951年成立以来,SHINCRON一直在孜孜不倦地开发设备以满足用户的严格要求。以下是其中具有特点的设备介绍。
9.1 连续设备
连续设备是用门阀将工艺室和装载/卸载室分开,因此工艺室不会暴露在大气中,可以保持高真空。因此具有以下优点。
- 成膜工艺的稳定
- 成膜工艺的缩短
缩短了达到成膜起始压力所需的时间
特别是排气、加热处理时间与成膜时间相同的工艺,CES可以实现非常高效的工艺 - パーティクルの低減
图9.1 (a) CES-2M和3M型号无需将整个系统安装在洁净室中,具有节省洁净室空间的优点。
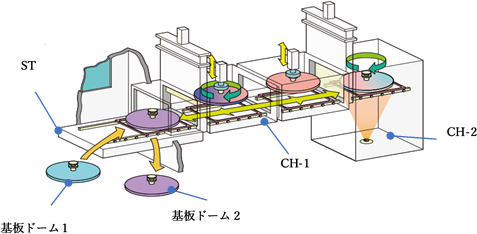
(a) CES-2M型 5)
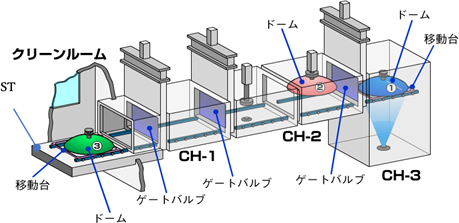
(b) CES-3M型 1)
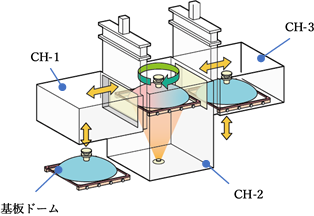
(c) CES-D型
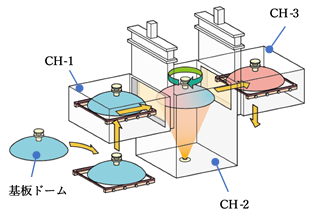
(d) CES-S型
图9.1 不同类型的CES概略图 1)
下面介绍不同类型CES的腔室作用。
| (a) CES-2M型 | ST: | 将基片伞架安装在移动台(机构)上。 |
|---|---|---|
| CH-1: | 装载/卸载 ・加热处理/缓慢冷却处理 ・从大气排气至真空,从真空充气至大气。 ・ST ⇔ CH-1 ⇔ CH-2的跨腔室机构存在下部位置。 ・成膜前的基片伞架从ST移动到CH-2的上部位置。 ・成膜后的基片伞架从CH-2的下部位置移动到CH-1的下部位置。 ・成膜前的基片伞架从CH-1移到CH-2。 ・成膜后的基片伞架返回下部,充气至大气,移至ST。 |
|
| CH-2: | 执行成膜工艺。 ・CH-2始终保持在高真空状态。 ・成膜材料按所需数量储存,并每次向成膜的各层进行供应。 |
|
| (b) CES-3M型 | ST: | 将基片伞架安装在移动台(机构)上。 |
| CH-1: | 装载/卸载 ・加热处理/缓慢冷却处理 |
|
| CH-2: | 移动机构&后处理工艺 ・移动机构与CES-2M相同 ・在从CH-2移动到CH-1之前,进行防水处理等需要真空的+后处理。 |
|
| CH-3: | 执行成膜工艺。 | |
| (c) CES-D型 | CH-1: | 装载/卸载 加热处理/缓慢冷却处理 |
| CH-2: | 成膜工艺 | |
| CH-3: | 装载/卸载 ・加热处理/缓慢冷却处理 |
|
| (d) CES-S型 | CH-1: | 装载 |
| CH-2: | 装载 | |
| CH-3: | 卸载 ・后处理工艺 |
CES型可以适应各用户的安装布局。 被广泛用于大规模生产相机、眼镜和其他光学部件的防反射膜以及最多约20层的光学薄膜。
9.2 EPD
EPD(有效物理气相沉积Effective Physical vapor Deposition)是在IAD基础上进化和发展成的成膜方法,可以生产出低散射的超级多层膜。图9.2为EPD的概念图。
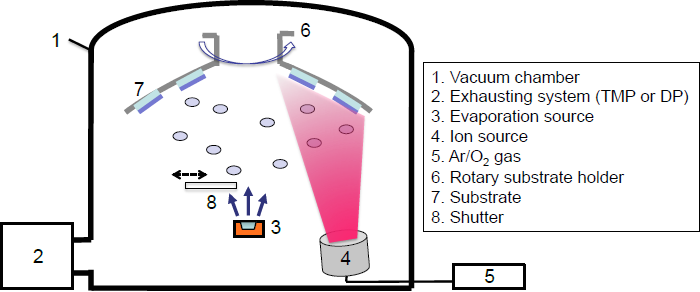
图9.2 EPD的概念图 2)
成膜过程中,用高密度离子照射基片伞架的一部分,其效果如下所示。
- 通过设置对制备薄膜进行高密度离子照射的区域和非离子照射区域,有了稳定成膜的缓和时间,促进薄膜的迁移,形成高密度的薄膜
- 通过高密度的离子照射,让薄膜较低的部位被蚀刻,只留下高密度的薄膜
通过EPD法进行了TiO2/SiO2、282层、总膜厚33μm的超级多层膜的成膜。图9.3和9.4为其表面AFM图像与横截面SEM图像。
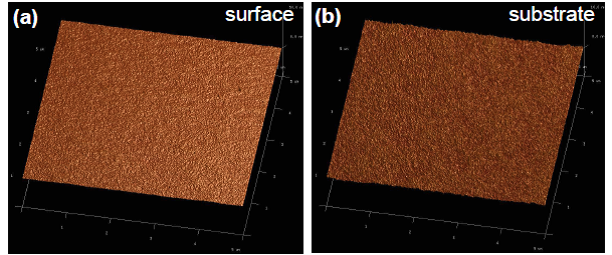
图9.3 TiO2/SiO2、282层、总膜厚33μm的超级多层膜的AFM图像 2)
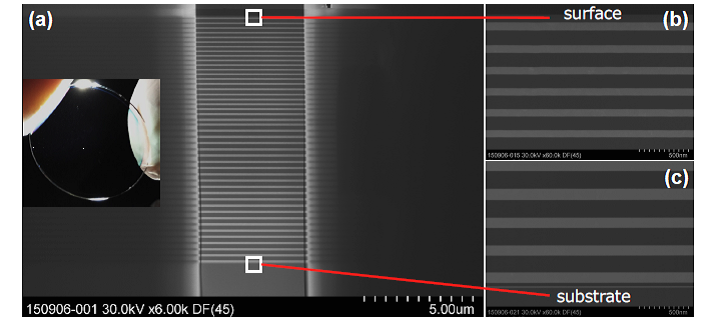
图9.4 TiO2/SiO2、282层、总膜厚33μm的超级多层膜的横截面SEM图像 2)
在IAD法中,存在增加离子电流密度,则Haze值(对应散射)下降但应力增加的趋势。如图9.5所示,可以看出,在同等HAZE值的情况下, EPD法的成膜应力更低。因此EPD有望适用于需要低损耗、高激光诱导损伤阈值(LIDT:Laser-Induced Damage Thresholds)的激光光学类产品。
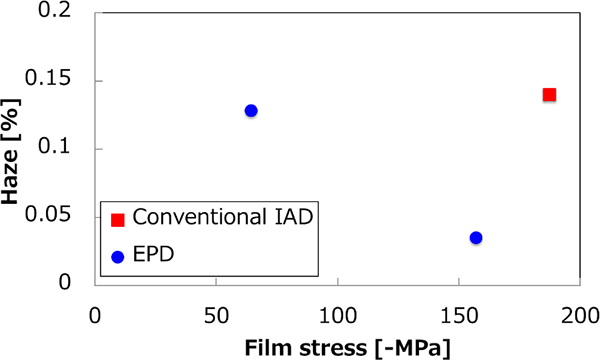
图9.5 一般IAD法与EPD的应力比较 2)
9.3 RAS
上面5.2.5中描述的RAS法的详细特点说明如下。
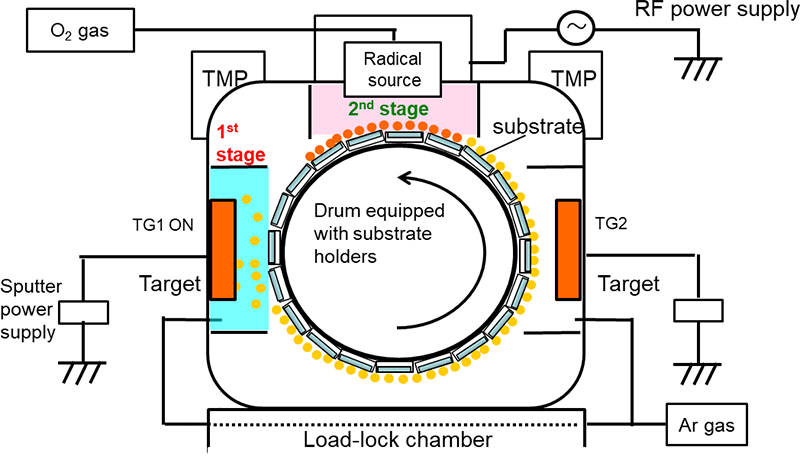
图9.6 RAS概略 3)
真空室包括用于装载/卸载基片的CH-1与配备高真空抽气系统、靶和激化源的CH-2。
9.3.1 靶部
在高成膜速率的金属模式区域内成膜,避免了图5.17所示的反应性溅射中的活性气体迟滞现象。这样可以防止图5.18中所述的靶表面的异常放电。图9.7为RAS-1100B中使用40kwh后的硅靶表面照片。硅靶是对光学薄膜所必需的低折射率材料SiO2进行成膜时所使用的材料。反应性溅射法中,SiO2成膜最容易出现异常放电,是一种很难稳定成膜的材料。
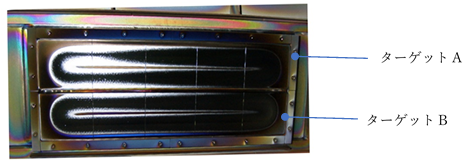
图9.7 RAS-1100B中硅靶使用10kwh时后的表面照片 1)
针对图5.18所述的阳极消失,通过采用交流溅射(双阴极Dual Cathode)确保放电的稳定性。
下面介绍交流溅射的异常放电对策和阳极消失对策的原理。

图9.8 对靶施加电压的时间经过 1)
如图9.8所示,交替在靶A和B上施加高电压(40~100kHz),以半个周期为单位始终被施加在靶的正极或负极,在正极时沉积在靶表面的不完全氧化物在施加在负极时被溅射,始终确保干净的金属表面。另外,不完全氧化物所致的离子电荷引起的异常放电如图9.9所示为正极时,会被电子中和。
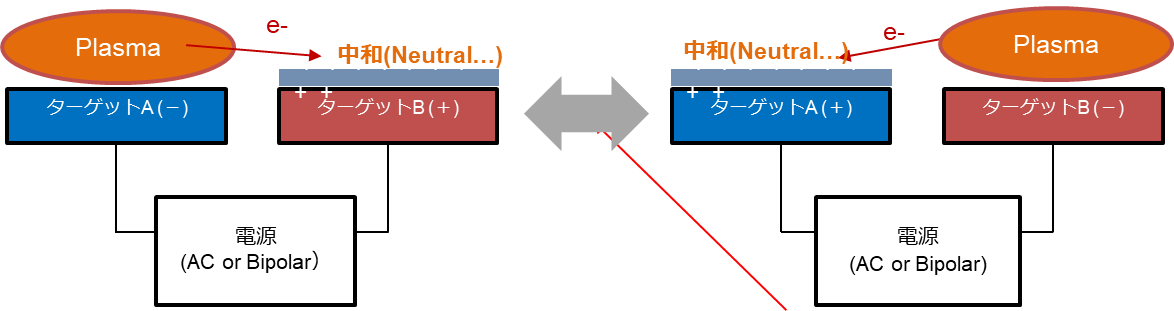
图9.9 防止靶部异常放电的概略 1)
9.3.2 基片温度
图9.10显示了RAS成膜过程中的基片温度变化。当进行总膜厚为3.8μm的IR截止滤光片的成膜时,标准成膜时间为148分钟,基片温度从室温上升到约170℃,但在低温成膜条件下,成膜时间增加,但基片温度下降到106℃、86℃。如果是这样的温度升高,也可以适用于树脂基片。
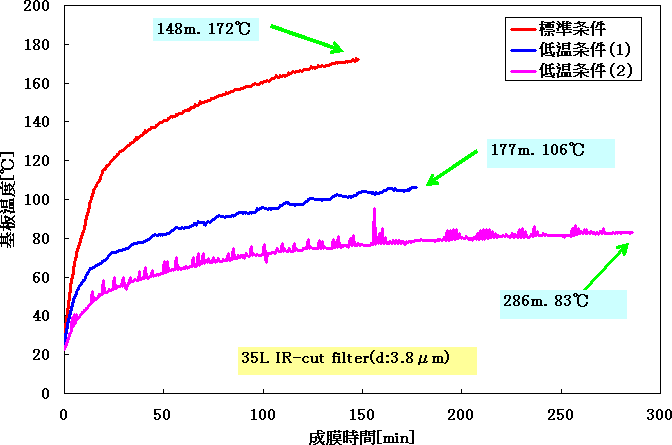
图9.10 RAS 成膜过程中的基片温度变化 3)
9.3.3 成膜示例
1)制备混合膜
如图9.6所示,工艺室具备两组靶对。从而能够进行图9.11所示的混合膜的成膜工艺。通过选择各靶对的功率比,可以自由地获得复合金属的混合比。
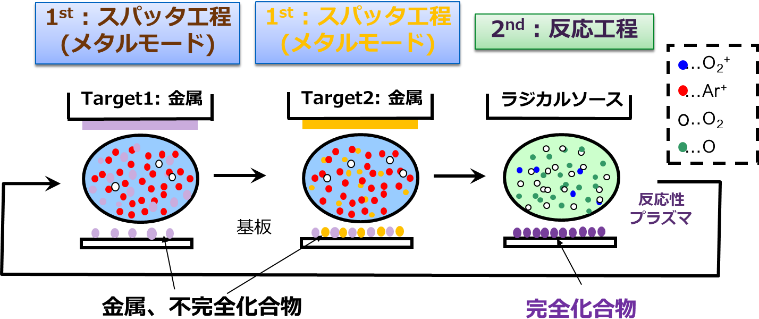
图9.11 用RAS进行两种金属的成膜 3)
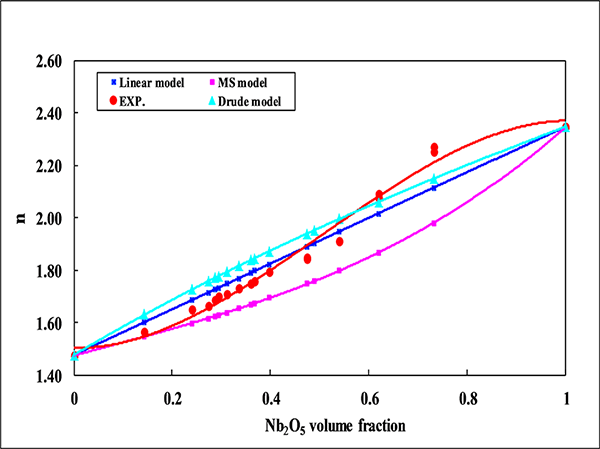
图9.12 通过RAS创造中间折射率 3)
在设计光学滤光片时,人们早就知道通过使用具有三种或更多折射率的物质可以获得特性优良的光学滤光片,但在实际上想要形成具有任意折射率的薄膜却很困难。因此一般会组合两种高/低折射率的物质,作为等价膜进行设计。采用RAS可以很容易地获得图9.12所示的中间折射率。通过利用中间折射率,即使入射角度变化很大,也可以很容易地实现s偏光与p偏光分离的偏振分光器(PBS:polarizing Beam Splitter)。其成膜示例如图9.13所示。可以看出,即使入射角度变化为±12°,薄膜也可立即具备利他的分光特性。

图9.13 利用中折射率制作的棱镜型PBS在0°和±12°入射角下的分光特性 3)
3)各种光学薄膜


图9.14 宽带防反射膜(AR) 1)
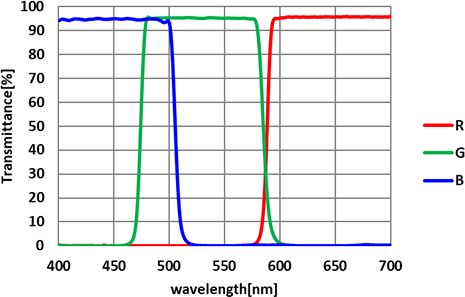
图9.15 RGB滤光片 1)

图9.16 IR截止滤光片 1)

图9.17 陷波滤波器(负滤光片) 1)

图9.18 带通滤光片 1)
9.4 SLS
在光学薄膜领域有着良好业绩的RAS法经过改善成为适用于电子部件领域的设备
作为电子部件领域的设备,在RAS的基础上进行改善的要点如下所示。
- 支持洁净室
- 支持晶圆装载
- 阶梯覆盖性(用电介质覆盖100nm的凹凸表面)良好的成膜
TC-SAW(Temperature Compensated Surface Acoustic Wave) 的SiO2成膜应用
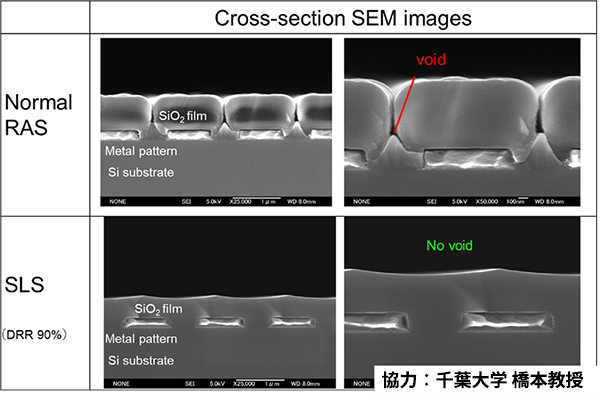
图9.19 通过SLS改善阶梯覆盖性 1)
9.5 P-RAS
P-RAS是一直以来始终有着强烈需求的、用于研究的小型RAS设备。
传统的RAS中,溅射和反应工艺在空间上分离,而P-RAS在时间上分离溅射成膜与反应工序。是一款适用于探索新材料的设备。

图9.20 P-RAS的外观 1)
表9.1 P-RAS概要规格 4)
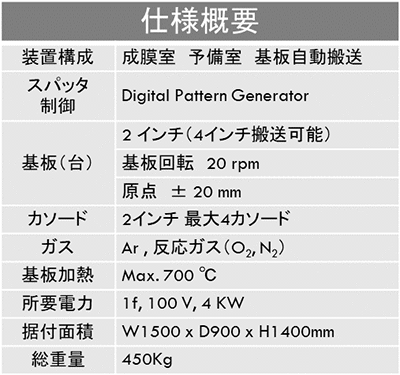
图9.91和9.22显示了由P-RAS制备的(Er0.1Y0.9)2Zr2O7的SEM图像和性能。
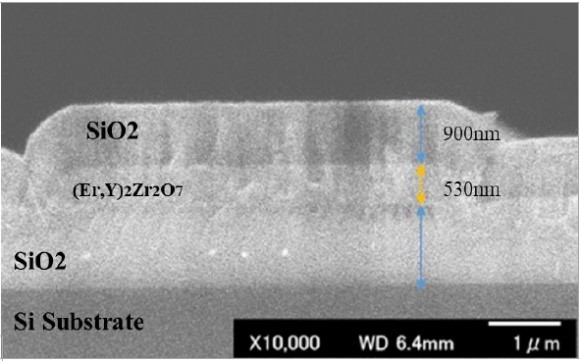
图9.21(Er0.1Y0.9)2Zr2O7波导的横截面SEM图像 4)

图9.22 (Er0.1Y0.9)2Zr2O7波导的光增益特性与激励的关系 4)
9.6 PMC
下面介绍用于SAW等电子部件的高质量金属电极用成膜设备PMC系列的特点。
PMC系列设备的特点如下所示。
- 预真空进样室和成膜室分离结构
极限压力为10-5Pa,可以始终在10-5Pa的高真空条件下进行成膜 - 成膜工艺为EB(电子束)蒸镀
特殊的炉膛内衬结构 - 在基片旋转中心配置EB和石英晶体膜厚仪的结构
具有上述特点的设备可以实现以下成膜。
- 剥离成膜
- 精确的膜厚控制
- 低表面粗糙度的金属薄膜
- 比电阻接近块状体电阻的金属薄膜
- 厚度分布均匀的金属薄膜(批次内、批次间)
- 比电阻稳定的合金薄膜
- 高反射率的金属薄膜
铝是一种经常被用作电子部件电极的材料,但由于其是活性物质,很容易被氧化,且熔点低,因此容易发生突起。因此铝是一种很难获得光滑表面的材料。与铝的传统设备相比,使用PMC的铝表面SEM图像如下所示。
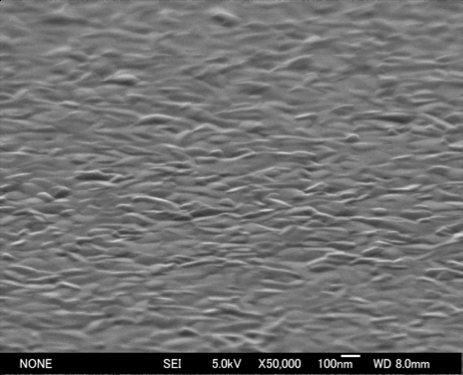
PMC制备的铝薄膜
R=92%@400nm, ρ=2.86μΩcm

传统的铝薄膜
R=90.2%@400nm,ρ=3.3μΩcm
图9.23 PMC和传统设备在铝成膜时的表面SEM图像比较 1)
另外,近年来移动终端需要小型/大电力的SAW4),PMC可以生产高取向性铝薄膜。PMC制备的铝薄膜的XRD测量结果如图9.24所示。
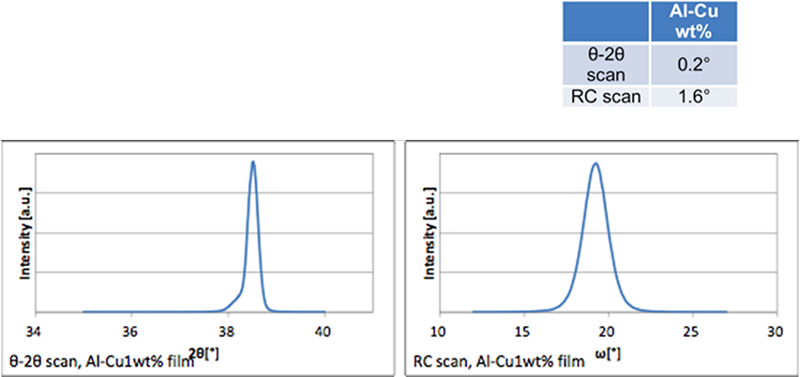
图9.24 PMC制备铝薄膜的取向性测量 1)
9.7 IBF(Ion Beam Figuring)
近年来,在高性能传感器、半导体和电子部件领域,对半导体与半导体、半导体与金属以及半导体与玻璃等组合的直接结合需求越来越大。另外,为了调整高频部件的频率、改善高分辨率摄像镜头的表面粗糙度等,利用IBF加工表面的用途也在扩大。针对这些用途,SHINCRON作为Bühler Alzenau(Leybold Optics业务)公司的经销商在日本销售IBF设备。
9.8 参考文献
- (株)SHINCRON,产品目录
- M.Miyauchi, K.Okada, S.Ito, Y.Jiang, S.Samori, E.Nagae: Scatterless SiO2/TiO2 multi-layered thick UV-IR cut filter prepared by EPD system, Optical Interference Coatings (OIC) (2016)
- 长江亦周,光学多层用溅射成膜设备, 2006真空机器和设备技术大全, 电子期刊杂志(2006)
- Kodai Miyagi, Yasuhito Tanaka, Ayuko Minowa, Ghent Nakamura, and Hideo Isshiki,Optical Gain in Mid-Refractive Index Contrast (Er0.1Y0.9)2Zr2O7 /SiO2 Waveguide Prepared by Radical Assisted Sputtering, Solid State Device and Materials(SSDM) 2019 (2019)
- Osamu Nakagawara, Masahiko Saeki, Masanobu Watanabe, Kazuhiro Inoue, Toshio Hagi, Takahiro Makino, Seiichi Arai: Epitaxially grown aluminum films with titanium intermediate layer on y rotated Y2X LiNbO3 piezoelectric single crystal substrates, Journal of Crystal Growth 249 (2003) 497–501




