4. プラズマ
真空,すなわち減圧状態では,気体の放電現象が大変重要である.薄膜作製プロセスにおいて,真空蒸着以外のプロセスは全て,気体の放電現象で生成するプラズマを利用したものである.
プラズマの現象は,実はたいへん複雑であるため詳しい説明は,専門書が多数出版されている.ここでは,ごく簡単に概略を説明する.
4.1 プラズマ中の反応
プラズマ中の電子あるいは,分子の励起とイオンの過程として以下のような反応が考えられる.1)12)
これらの反応が起きる確率は,それぞれの反応過程に対する断面積で表される.
電子をe(-1価),気体分子をA,B,Mとし,主な反応過程を示す.
4.1.1 励起とイオン化
- 電子衝突による励起とイオン化
- 励起
A + e → A* + e
AB + e → AB* + e - 解離
AB + e → A + B + e - 直接イオン化
A + e → A+ + 2e
AB + e → AB+ + 2e - 累積イオン化
A* + e → A+ + 2e
AB* + e → AB+ + 2e - 解離イオン化
AB + e → A+ + B + 2e
- 励起
- イオンや中性粒子の衝突による励起とイオン化
- 熱イオン化
気体が高温になると中性粒子の運動エネルギーが増加し,衝突によりイオン化を起こすような中性の高速粒子が生成される. - ペニングイオン化
A + B* → A* + e + B - 励起粒子同士の衝突によるイオン化
A* + B* → A+ + e + B
- 熱イオン化
- 光励起と光イオン化
気体に単色光を照射し,そのエネルギー(波長)を変化させるとある波長で吸収が起こり,気体は励起あるいはイオン化される.
4.1.2 再結合
- イオン−電子再結合
- 放射再結合
A+ + e → A* + hv - 二電子再結合
A+ + e → A*
A* → A** + hv
A* + B* → A** + B - 解離再結合
AB+ + e → A* + B* - 三体再結合
A+ + e + e → A + e
A+ + e + B → A + B
- 放射再結合
- イオン−イオン再結合
- 放射再結合
A+ + B– → AB + hv - 電荷交換再結合
A+ + B– → A* + B* - 三体再結合
A+ + B– + M → AB + M
- 放射再結合
- 負イオンによる反応2, 3 ,4, 5, 6)
負イオンの形成のしやすさは,電子親和力(electron affinity)で示される.すなわち電子親和力が大きいほど,その原子,分子は負イオンを形成しやすい.
誘電体を反応スパッタリングする場合,基板に照射される負イオンは薄膜の結晶性に大きく影響する.
4.2 放電開始電圧
4.2.1 直流電界
気体中で絶縁破壊が発生する電圧Vsは気体の圧力(p)とギャップ長(d)の積(pd)の関数であることをパッシェン(Paschen)が実験的に見出し8),その後のタウンゼント(Townsend)の実験9)10)を通して,次の関係式が得られている.1)
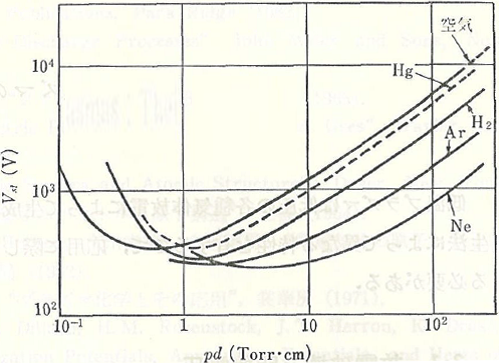
図4.1 各種ガスのパッシェン曲線 1)

ここで,B,Kは定数として扱うことができる.このV字型曲線の最小値となるところをパッシェンミニマムと呼ぶ.
そこでのpdより右側の部分では圧力を一定とするとVsは電極のギャップ長にほぼ比例する.気体の絶縁破壊では,電子と気体分子の衝突過程が現象を支配しており,気体の種類と圧力,およびギャップ長が決まれば,上式により絶縁破壊電圧を見積もることができる.
一方パッシェン曲線の左側の領域では,気体の圧力を一定とした場合,ギャップ長が短くなることに対応するので,電極間空間で電子,イオンが十分増殖しないうちにこれらの荷電粒子は対向電極に到達する.そのため,絶縁破壊が起こりにくくなりVsが上昇する.また,ギャップ長を一定とした場合は,気体の圧力が減少することに対応し,衝突数が低下するのでVsが上昇する.
4.2.2 高周波電界
高周波電界における開始電圧は,直流電界におけるpdに加えて,印加する高周波の周波数による影響が表れる.pd=1Torr・cm程度における開始電圧の周波数依存性を図4.2に示す.

図4.2 空気に関する放電開始電圧の周波数依存性 12)
図4.2中の各領域の特性を以下に示す.
- Ⅰ領域
- 低周波領域はほぼ直流電界と同様である.
- Ⅱ領域
- 中間周波数領域においては,イオンが電界の変化に追随できなくなり,放電空間にとどまる.故に陰極を衝撃するイオンの数は減少し,開始電圧は上昇する.(一般的に利用されている13.56MHzのRFプラズマが該当する)
- Ⅲ領域
- 高周波領域になると,電子も放電空間に細くされ始め,気体分子と衝突して頻繁にイオン化を行うため開始電圧は急激に減少する.
- Ⅳ領域
- さらに周波数が高い領域では,電子の完成により,電子の移動速度の位相は電界の位相より遅れ,電子は気体分子のイオン化に必要なエネルギーを電界から得ることができなくなる.このため開始電圧は徐々に上昇する.
4.3 直流放電プラズマ(グロー放電)
グロー放電(Glow Discharge)は,ガラス管の中に2枚の金属製電極を対向させて配置した放電管をもちいる.管内の圧力を0.1~10Torrとして,両電極に直流電圧を印加することにより発生することができる.グロー放電中の発光部分および暗部を図4.3に示す.

図4.3 直流放電中の電位V, 電界X, 空間電荷密度ρ, および電流密度j 1)
図4.3に,放電している時の管長方向の電位分布が図示する.陰極の近傍で急激に電位勾配があることにより,気体イオンが急激に加速されて陰極に衝突する.後に記述するスパッタリングは,この現象を利用し,薄膜作製を行う.1Vで加速された1価のイオン,電子のエネルギーを1eV(エレクトロンボルト)と表す.1eVは,温度に換算すると1eVが約1万度に相当する.
図4.3にVで示した電位分布は,2枚の金属電極の大きさが等しくかつ電極の大きさに対して電極間距離が十分大きいとみられるグロー放電に対して示したものである.しかし,実際の装置では電極に対して電極間距離は小さく,また陽極(アース)が陰極と比べ大きい場合が多い.この場合の電位分布を図4.4に示す.
発光部について見ると,陰極および陽極暗部は電極に接し,陽光柱は短くなってFaraday暗部がなく,負グローに続いていることがわかる.電位は陰極部で急激に上昇し発光部では一様である.この電位をプラズマ電位Vs(plasma potential)という.図4.3との違いは,プラズマ電位は陽極電位に対しプラスの電位をもつことである.

図4.4 装置におけるグロー放電の電位分布 1)
プラズマが真空容器をはじめ電極や基板などの固体に接すると,図4.5に示したように,その表面にシース(sheath)と呼ばれる空間電荷層が形成される.

図4.5 シースにおける電位分布 12)
一般に,プラズマの電子温度はイオン温度より高いので,軽くて速度の速い電子によって固体表面の電位は,図4.5に示すように,プラズマに対して負になる.この電位はポアソン(Poisson)の式に従って形成され,イオンを加速するとともに電子を減速または反射する.したがって,この空間電荷層には,イオンが過剰となるイオンシースが形成される.すなわち,プラズマの内部の電気的中性を保つために,電子をはじめ負イオンを含めた負電荷の電流密度と正イオン電流密度とが等しくなるような電界がイオンシース(厚さはデバイ長の数倍程度)に形成されイオンを加速する.
4.4 高周波放電プラズマ
高周波放電プラズマとしては平行平板型(容量結合型)とコイル型(誘導結合型)に大別される.図4.6(a)に容量結合型,図4.6(b)に誘導結合型の概略図を示す.

(a) 容量結合型プラズマ(CCP)

(b) 誘導結合型プラズマ(ICP)
図4.6 高周波放電プラズマ 12)
4.4.1 容量結合型プラズマ
図4.6(a)の装置を用いてプラズマを生成すると,まず,基板(ターゲット)には電子,イオンが飛び込んでくる.12)しかし,電子の平均速度(~106 m/s)はイオンのそれ(~104 m/s)よりはるかに速いので,電子電流はイオン電流よりはるかに大きくなる.ところが,基板はその表面に負の電荷が蓄積し,プラズマに対して負の電位にバイアスされるので,電子は追い返されるようになるとともにイオンを逆に引き寄せる(図4.5参照).そして,電子電流とイオン電流が等しくなる電位で平衡になる.この時の基板の電位の負の直流成分をセルフバイアス Vdc と称する.なお,この電圧は基板が電気的にフローティング状態にあるとき(図 4.6(a)においてブロッキングコンデンサを接続したとき)のみに発生する.一方,プラズマの電位 Vsは基板および真空容器に対して正となるので,表面に形成されるイオンシースには(Vs+Vdc)=Vwの電圧が掛り,この電圧で加速されたイオンの衝撃を基板は受けることになる.

図4.7 容量結合プラズマの等価回路 12)
図 4.6(a)の等価回路は図4.7のようになる.ここで,C1とC2はシースの静電容量,R1とR2はシースの直流抵抗,D1とD2はダイオード,ZPはプラズマのインピーダンスである.プラズマと電極の境界に形成されるイオンシースは,一方向の電流しか流さないのでダイオードと等価になる.さらに,プラズマは良導体であるので,高周波電界の大部分はプラズマと直列なイオンシースの容量に掛かると考えられる.したがって,放電軸方向に生じた電界はシースに掛かり,プラズマ-シース間の整流作用(ダイオード)によってシースに直流電圧(セルフバイアス電圧)を生ずる.この電圧はシースに掛かる高周波電圧に比例する.
したがって,一般に,時定数 C1,R1とC2,R2は高周波の周期に比べて十分に大きいので,C1とC2に発生する電圧V1とV2は,ZPを無視し高周波電圧の最大振幅をVRFとすると,

一方,シースの容量Cは,電極の面積をA,シースの厚さをdとすると,C=A/dであるから上式を用いて以下のようにあらわせる.

いま,両電極に流れるイオン電流密度が等しく,シース中の衝突を無視すると,Child-Langmuir の空間電荷制限電流の式(26)のV∝d4/3を用いて,次の関係が得られる.

この式から,小さい電極(基板またはターゲット)には大きな電圧が掛かかり,その分イオンの衝撃を受けることが分かる.
4.4.2 誘導結合型プラズマ
図4.6(b)に誘導結合型装置の基本構成図を示す.12)コイルに高周波(通常13.56 MHz)電流Jを供給すると,その周囲にマックスウエル(Maxwell)の方程式に従って磁場Bが誘起される.(μ0:真空中の透磁率)

この磁場が時間的に変化すると,この磁場を打ち消すように電界Eが発生し(Lenzの法則)電子を加速する.この誘導電界によって加速された電子が,ガス分子などと衝突してプラズマを生成・維持することになる.高周波電磁場は,プラズマの表皮効果によって,プラズマの中を指数関数的に減少しながら浸透する.電界の強度が1/e(e:自然対数の底)になる距離を表皮厚さと称し,プラズマ角周波数が高周波の角周波数より十分に大きい(高密度)ときの表皮厚さは,光速をプラズマ角周波数で割った値となる.
4.5 参考文献
- 小沼光晴,プラズマと成膜の基礎,日刊工業新聞社(1985)
- 金原粲,他,オプトエレクトロニクス分野を中心としたスパッタリング法による薄膜形成・制御技術,技術情報協会(2006)
- K.Ishibashi, K.Hirata, and N.Hosokawa, J.Vac.Sci.Technol.,A10,(4)(1992)
- J.J.Cuomo, R.J.Gambino, and R.Rosenberg, J.Vac.Sci.Technol.,11(1974)
- Y.Shintani, K.Nakanishi, T.Takawaki, and O.Tada, Jpn. J.Appl. Phys., 14(1975)
- J.M.E.Happer, J.J.Cuomo, R.J.Gambino, H.R.Kahfman and R.S.Robinson, J.Vac.Sci.Technol., 15(1978)
- 小林信一,真空の放電現象,J.Vac.Soc.Jpn, Vol.56,No.1,(2013)
- F. Paschen: Annalen der Physik und Chemie, 5 (1989) 69
- J. S. Townsend, Nature, 62 (1900) 340.
- J.S.Townsend,Phil.Mag.S.6, 1 (1901) 198 in 12, p.27
- B.Chapman, Glow Discharge Process, John Wiley and Sons, New York(1980).
- 岡本幸雄,プラズマの基礎,J.Vac.Soc.Jpn, Vol.59, No.7, (2016)




